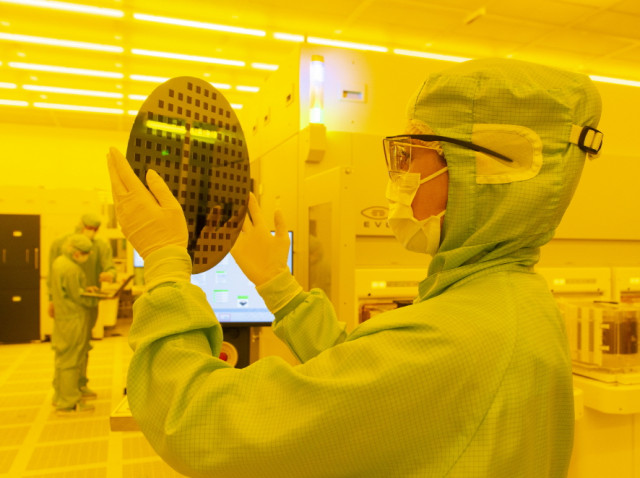
공정 개발 및 검증 작업 / 사진. EVG
첨단 반도체 설계 및 칩 통합 솔루션 기업 EV 그룹(이하 EVG)이 2월 19~21일(수~금)까지 서울 코엑스에서 열리는 세미콘 코리아 2025에서 혁신적인 웨이퍼 본딩 및 리소그래피 기술을 선보인다.
EVG는 이번 전시회에서 특히 업계 선도적인 'IR LayerRelease™' 템포러리 본딩/디본딩(TB/DB) 솔루션에 초점을 맞출 예정이다. 이 솔루션은 AI 가속기와 고성능 컴퓨팅(HPC)의 핵심 부품인 HBM(고대역폭 메모리) 및 3D DRAM 개발 및 생산에 필수적인 기술이다.
토르스텐 마티아스 EVG 아태지역 세일즈 디렉터는 "차세대 HBM과 3D DRAM 개발 및 양산을 가속화하는 것은 한국 반도체 업계의 최우선 과제이며, 이는 TB/DB 기술 혁신을 필요로 한다"라며 "EVG의 IR LayerRelease 기술은 기계적 디본딩의 필요성을 없애고, 실리콘 캐리어 사용을 지원하며, 프런트엔드 호환성을 제공하는 등 다양한 이점을 제공한다"라고 설명했다.
HBM과 3D DRAM은 높은 대역폭, 낮은 지연 시간, 저전력 특성을 제공해 AI 학습 애플리케이션 수요에 대응하는 핵심 기술로 주목받고 있다. TB/DB는 이러한 첨단 메모리 칩 제조에 필수적인 칩 적층 공정의 핵심 기술이다.
EVG의 IR LayerRelease 솔루션은 기존 기계적 디본딩 방식의 한계를 극복하고, 정밀성, 높은 수율, 낮은 소유 비용, 환경 영향 감소 등 다양한 이점을 제공해 글로벌 메모리 반도체 제조사들에게 새로운 대안을 제시한다.
EVG는 세미콘 코리아 2025에서 AI, HPC, 첨단 패키징, 지속 가능한 반도체 제조를 위한 다양한 혁신적인 공정 솔루션을 선보일 예정이다.

